芯片热处理设备 HTR-4立式4寸快速退火炉
HTR-4立式4寸快速退火炉
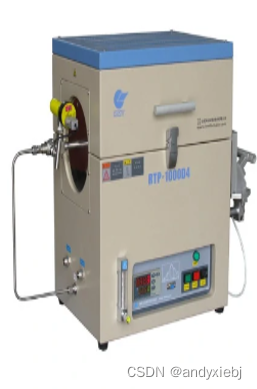
HTR-4立式4寸快速退火炉(芯片热处理设备)广泛应用在IC晶圆、LED晶圆、MEMS、化合物半导体和功率器件等多种芯片产品的生产,和欧姆接触快速合金、离子注入退火、氧化物生长、消除应力和致密化等工艺当中,通过快速热处理以改善晶体结构和光电性能,技术指标高、工艺复杂、专用性强。
主要应用领域:
1.快速热处理(RTP),快速退火(RTA),快速热氧化(RTO),快速热氮化(RTN);
2.离子注入/接触退火;
3.金属合金;
4.热氧化处理;
5.化合物合金(砷化镓、氮化物等);
6.多晶硅退火;
7.太阳能电池片退火;
8.高温退火;
9.高温扩散。
产品特点:
- 可测大尺寸样品:可测单晶片样品的尺寸为4英寸。
- 压力控制系统创新设计:高精度控制压力,以满足不同的工艺要求。
- 存储热处理工艺:方便工艺参数调取,提高实验效率,数据可查询。
- 快速控温与高真空:升温速率可达150℃/s,真空度可达到10-5Pa。
- 程序设定与气路扩展:可实现不同温度段的控制,进行降温段的自动转接,并能够对工艺菜单进行保存,方便调用。采用MFC控制气体流量,实现不同气氛环境(真空、氮气等)下的热处理。
- 独特的腔体空间设计:保证大尺寸样品的温场均匀性 ≤1%。
- 全自动智能控制:采用全自动智能控制,包括温度、时间、气体流量、真空、冷却水等均可实现自动控制。
- 超高安全系数:采用炉门安全温度开启保护、温控器开启权限保护以及设备急停安全保护三重安全措施,全方位保障设备使用安全。
- 主要技术参数:
| 样品尺寸 | 4英寸(直径100mm) |
| 控温范围 | RT~1200℃ |
| 升温速率(max) | 150℃/s |
| 高温段降温速率(max) | 1200℃/min |
| 控温精度 | ±0.5℃ |
| 温场均匀性 | ≤1% |
| 气体流量 | 标配1路MFC控制(氮气)可扩展至4路 |
| 压力控制 | ~1bar,±100Pa |
| 工艺条件 | 支持真空、氧化、还原、惰性气体等工艺气氛,一键设置通过软件控制真空及通气时间 |
